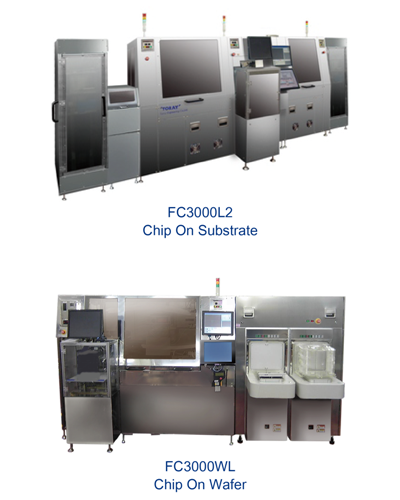
隨著半導體行業快速向小型化和高精度發展,Toray Engineering 提供獨特和領先技術的解決方案產品陣容含括於 TSV 3D貼裝、FOWLP、光學設備和其他用途的各種鍵合機,並專注在處理3D封裝的各種程序中堆疊應用,如用於CUF、NCP、NCF、Cu Pillars 、TSV晶片堆疊等各種製程。

東麗工程株式會社(Toray Engineering Corporation)是總部位於日本的綜合性工程及自動化生產設備製造公司,其業務包括生產和銷售用於平板顯示器及半導體生產的自動化生產檢測設備及各種製造業使用的檢測與監控儀器等。Toray 旗下INSPECTRA系列AOI在提供超高精度的晶圓表面缺陷全自動檢測的同時, 具有速度快,穩定度高的特點。此外,TORAY INSPECTRA AOI對Bumping, Sawn Wafer 等製程提供有效並獨特的檢測方案。Toray 還提供業內高精度的TCB/FC設備,用於chip to wafer/ substrate的 高精度die bonding solution。 同時,Toray可以提供客戶不同應用的設備,FC/TCB bonder有不同精度速率和設備來達到客戶不同的需求。